HOME > 膜厚測定システム > 膜厚測定アプリケーション > シリコン熱酸化膜の膜厚測定
シリコン熱酸化膜の膜厚測定
シリコンウエハを高温で酸化させる熱酸化処理は,緻密で安定なシリコン酸化膜を作ることができます. シリコン熱酸化膜は,膜厚の制御精度が高く,屈折率が安定しているため,分光エリプソメトリーや分光干渉法などの光学的な膜厚測定における標準的な膜サンプルとして使用されます.
キャリブレーションウエハの膜厚測定と精度検証
本測定では,キャリブレーション膜厚データ付きのシリコン熱酸化膜(SiO2)をサンプルにして,光学膜厚測定システムDF-1045Rを使って膜厚測定を行った結果を示します. 今回サンプルにしたキャリブレーションデータ付きシリコン熱酸化膜は,膜厚が異なる6領域が1枚のウエハに成膜されていて,単一波長のエリプソメーターで測定したキャリブレーション膜厚データシートが添付されています.
 図1 キャリブレーションデータ付きシリコン熱酸化膜サンプル
図1 キャリブレーションデータ付きシリコン熱酸化膜サンプル
キャリブレーション膜厚データは,単波長(波長:632.8 nm)のエリプソメーターで測定されています. 単波長エリプソメーターの場合,波長:632.8 nmにおけるSiO2の屈折率データ(n = 1.457,k = 0.000)のみを使いますが,スペクトルデータから膜厚を測定する場合,測定波長をカバーするSiO2の光学定数スペクトルが必要になります. 光学定数スペクトルは,G. E. Jellisonの文献を参照しました [1] .
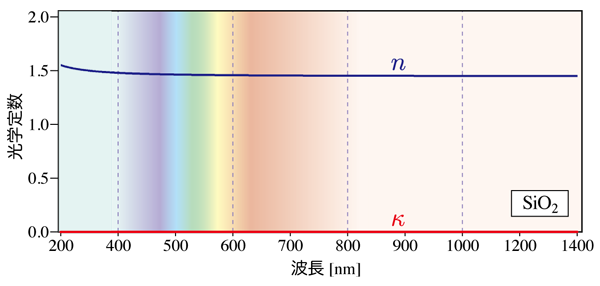 図2 シリコン熱酸化膜の光学定数スペクトル
図2 シリコン熱酸化膜の光学定数スペクトル
[1] G. E. Jellison, Jr: "Optical functions of GaAs,GaP, Ge determined by two channel polarization ellipsometry", Opticals Materials, 1 (1992) pp.151-160.
図3,図4に膜厚測定光学系を示します. 図3は光学膜厚測定システム DF-1045Rを使用した構成例,図4は簡易反射ステージ SS-Rシリーズを使用した構成例です.
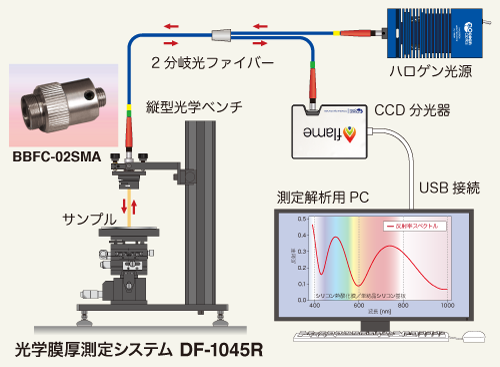 図3 光学膜厚測定システム DF-1045Rを使用した光学系構成例
図3 光学膜厚測定システム DF-1045Rを使用した光学系構成例
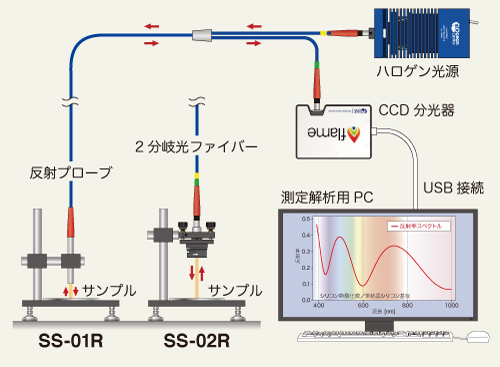 図4 簡易反射ステージ SS-Rシリーズを使用した光学系構成例
図4 簡易反射ステージ SS-Rシリーズを使用した光学系構成例
シリコン熱酸化膜サンプルの膜厚が異なる各測定領域 #1 ~ #5 で反射率スペクトルを測定し,フィッティング解析から膜厚測定を行いました. 膜厚の範囲は,約100nm ~ 510nmです.
スペクトルフィッティング解析の詳細については,スペクトル解析ソフトウエア SCOUTの技術資料をご覧ください.
各領域の反射スペクトルとフィッティング結果を示します.
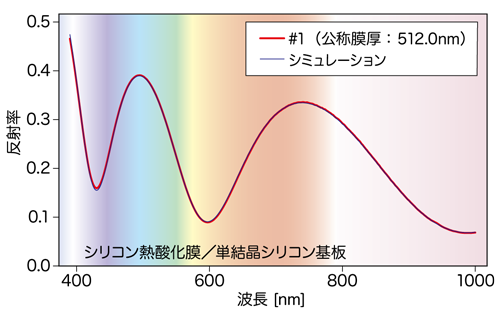 図5 測定領域#1(公称膜厚:512.0 nm)の反射スペクトルとフィッティング結果
図5 測定領域#1(公称膜厚:512.0 nm)の反射スペクトルとフィッティング結果
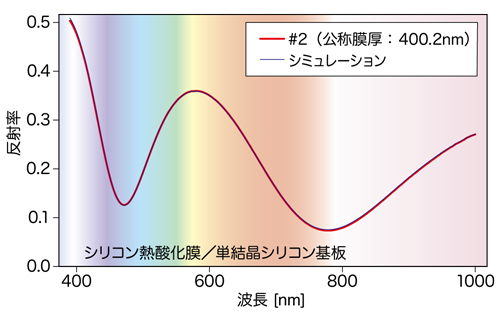 図6 測定領域#2(公称膜厚:400.2 nm)の反射スペクトルとフィッティング結果
図6 測定領域#2(公称膜厚:400.2 nm)の反射スペクトルとフィッティング結果
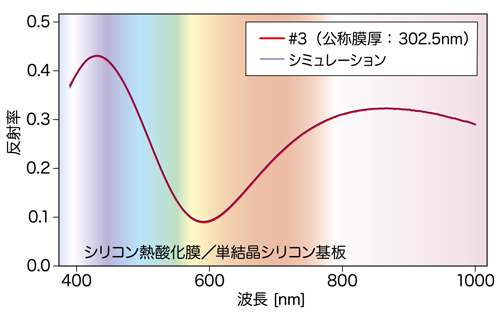 図7 測定領域#3(公称膜厚:302.5 nm)の反射スペクトルとフィッティング結果
図7 測定領域#3(公称膜厚:302.5 nm)の反射スペクトルとフィッティング結果
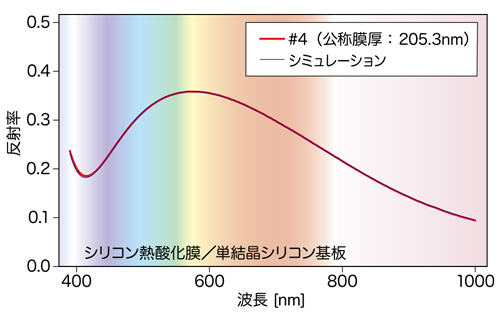 図8 測定領域#4(公称膜厚:205.3 nm)の反射スペクトルとフィッティング結果
図8 測定領域#4(公称膜厚:205.3 nm)の反射スペクトルとフィッティング結果
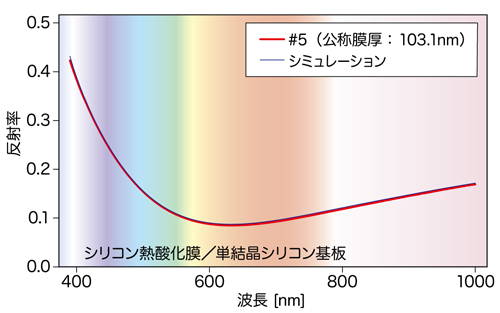 図9 測定領域#5(公称膜厚:103.1 nm)の反射スペクトルとフィッティング結果
図9 測定領域#5(公称膜厚:103.1 nm)の反射スペクトルとフィッティング結果
いずれの膜厚に対しても,非常によい収束が得られています.
図8,図9で各領域における測定膜厚値とメーカーから提供されているキャリブレーションデータ(公称膜厚値)を比較します. いずれの膜厚領域でも,膜厚の違いは数ナノメーター以下であり,良好な膜厚値の相関が得られています.
 図10 測定膜厚値と公称膜厚値との比較-1
図10 測定膜厚値と公称膜厚値との比較-1
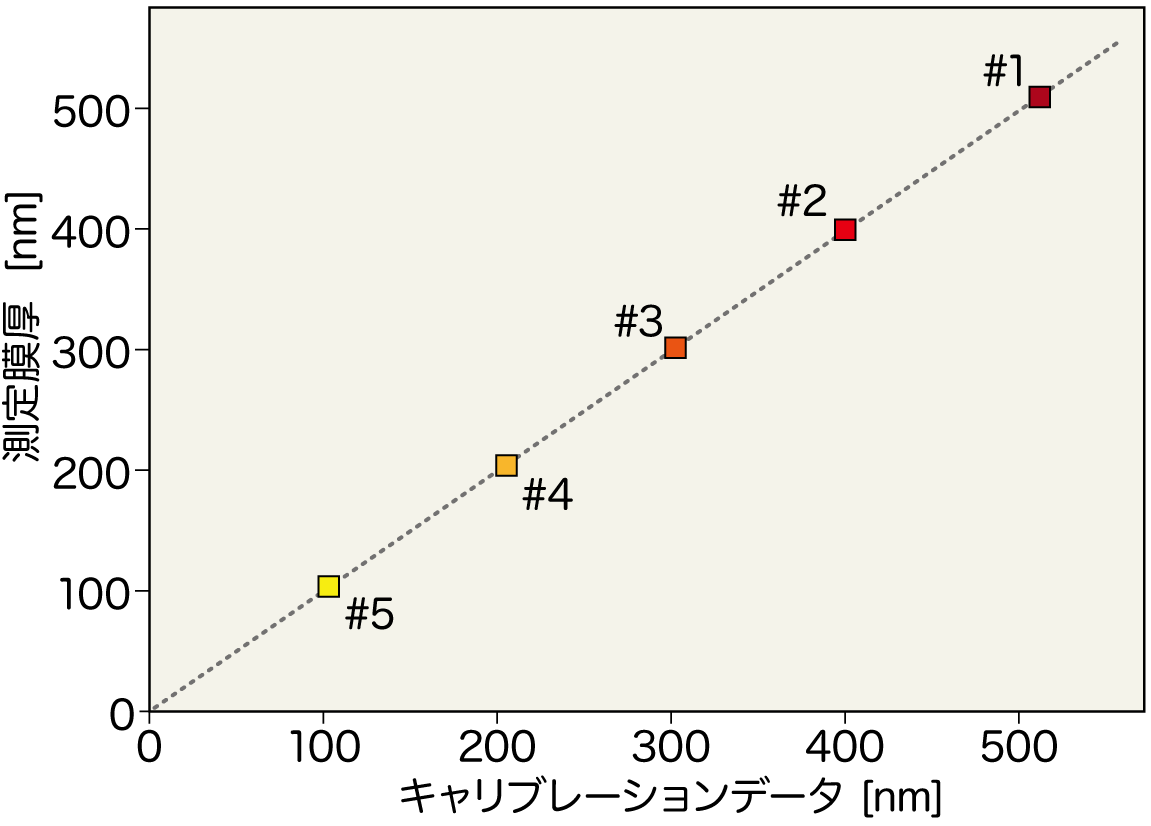 図11 測定膜厚値と公称膜厚値との比較-2
図11 測定膜厚値と公称膜厚値との比較-2
シリコン熱酸化膜のような誘電体膜の場合,膜厚が数十ナノメーターより厚ければ,分光エリプソメーターほど高価な装置を使わなくても,干渉分光法で膜厚,光学定数の測定を行うことができます.


