HOME > 膜厚測定システム > 膜厚測定アプリケーション > 誘電体膜の膜厚測定
誘電体膜の膜厚測定
金属酸化物に代表される誘電体は誘電体多層膜などの光学膜材料,半導体プロセスにおける絶縁膜材料として重要です. 誘電体膜は可視領域で透明なため,分光エリプソや分光干渉法を使って非破壊・非接触に膜厚測定することができます. 本稿では,光学膜厚測定システムDF-1045Rを使った誘電体膜の膜厚測定例を示します.
代表的な誘電体膜の膜厚測定
シリコン基板上にECRプラズマで成膜されたシリコン酸化膜(SiO2),アルミナ(Al2O3),ジルコニア(ZrO2)の膜厚を測定しました. ここでは,光学膜厚測定システムDF-1045Rを使った膜厚測定について解説します.
図1にサンプルの外観を示します. (a) 単結晶シリコン基板, (b) シリコン酸化膜(SiO2,膜厚:約102nm), (c) アルミナ(Al2O3,膜厚:約90nm), (d) ジルコニア(ZrO2,膜厚:約65nm)です.
 図1 誘電体膜サンプルの外観. (a) シリコン基板, (b) SiO2, (c) Al2O3, (d) ZrO2
図1 誘電体膜サンプルの外観. (a) シリコン基板, (b) SiO2, (c) Al2O3, (d) ZrO2
分光干渉法を用いた膜厚測定では,反射率スペクトルが既知の物質を使ってリファレンス測定する必要があります. リファレンスには,反射率がある程度高く,誘電関数から正確に反射率が計算でき, 経時変化のない材料をします. 可視領域を中心とした測定では,自然酸化膜付きシリコン基板などを使用するのが一般的です. 本測定では,リファレンスに単結晶シリコン基板を使用し,光学定数スペクトルは,G. E. Jellisonの文献を参照しました [1] .
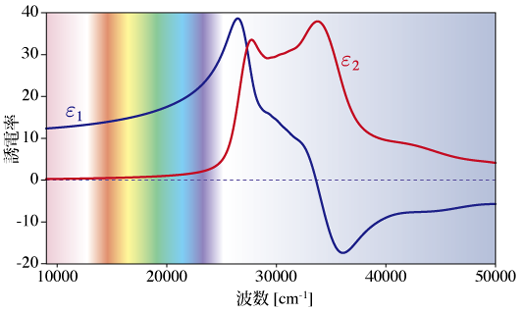
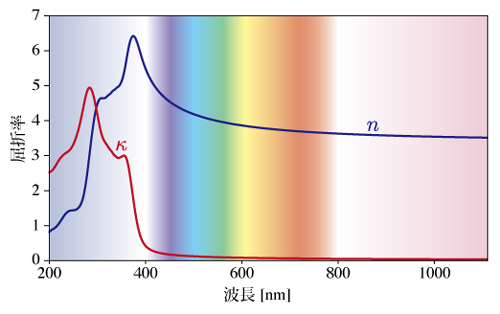 図2 単結晶シリコンの誘電関数と光学定数スペクトル
図2 単結晶シリコンの誘電関数と光学定数スペクトル
[1] G. E. Jellison, Jr: "Optical functions of GaAs,GaP, Ge determined by two channel polarization ellipsometry", Opticals Materials, 1 (1992) pp.151-160.
リファレンスの反射スペクトル, 試料の反射スペクトル, バックグラウンドスペクトルをそれぞれ測定し, 次式から試料の反射率スペクトルを求めます.

図3,図4に膜厚測定光学系を示します. 図3は光学膜厚測定システム DF-1045Rを使用した構成例,図4は簡易反射ステージ SS-Rシリーズを使用した構成例です. 本測定は,図3の光学膜厚測定システム DF-1045Rを使用して測定しました. 簡易的には,図4の簡易反射ステージを使用する方法もあります.
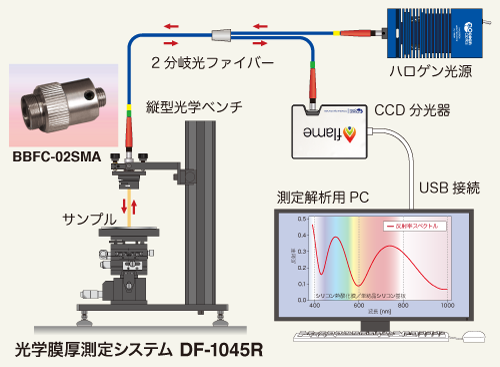 図3 光学膜厚測定システム DF-1045Rを使用した光学系構成例
図3 光学膜厚測定システム DF-1045Rを使用した光学系構成例
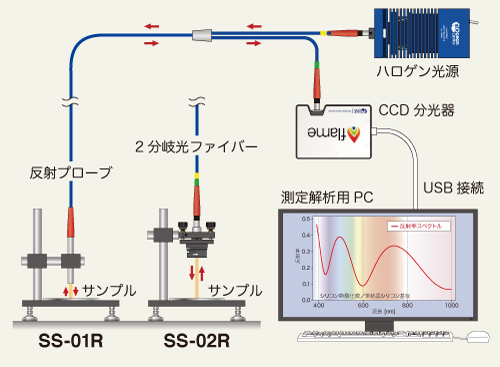 図4 簡易反射ステージ SS-Rシリーズを使用した光学系構成例
図4 簡易反射ステージ SS-Rシリーズを使用した光学系構成例
単結晶シリコン基板リファレンスとして, シリコン酸化膜(SiO2),アルミナ(Al2O3), ジルコニア(ZrO2)各サンプルの反射率スペクトルを測定し,フィッティング解析から膜厚測定を行いました. 測定波長範囲が材料のバンドギャップより長波長であるため,紫外領域にある電子分極の吸収をLorentz振動子で表した単純な光学モデルで解析しました.
スペクトルフィッティング解析の詳細については,スペクトル解析ソフトウエア SCOUTの技術資料をご覧ください.
シリコン酸化膜(SiO2),アルミナ(Al2O3), ジルコニア(ZrO2)各サンプルの反射スペクトルとフィッティング結果を示します.
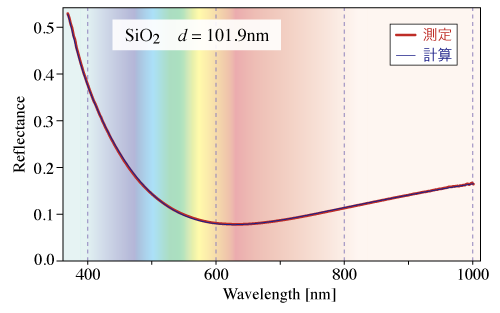 図5 シリコン酸化膜(SiO2)の反射スペクトルとフィッティング結果
図5 シリコン酸化膜(SiO2)の反射スペクトルとフィッティング結果
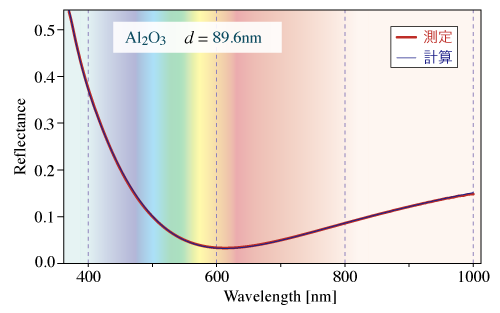 図6 アルミナ(Al2O3)の反射スペクトルとフィッティング結果
図6 アルミナ(Al2O3)の反射スペクトルとフィッティング結果
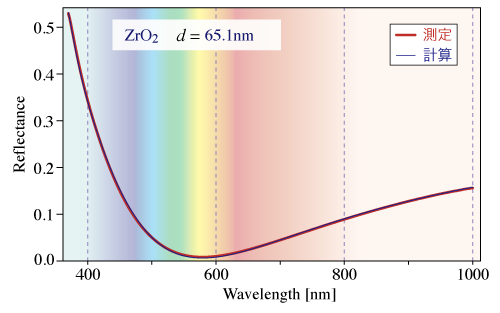 図7 ジルコニア(ZrO2)の反射スペクトルとフィッティング結果
図7 ジルコニア(ZrO2)の反射スペクトルとフィッティング結果
いずれのサンプルに対しても,非常によい収束が得られています. 可視の測定波長領域において透明なサンプルで,バンドギャップ波長が測定領域から離れている場合,単純なLorentz振動子でも十分に精度の高いスペクトルフィッティング解析をすることができます.
図8にフィッティング解析で得られた各サンプルの屈折率スペクトルを示します. 消衰係数は,いずれの誘電体膜でも全測定波長領域でゼロに収束しました.
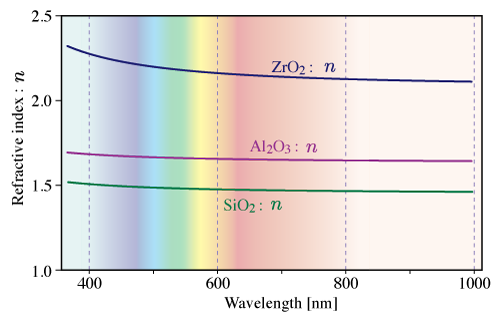 図8 フィッティング解析で得られた各サンプルの屈折率スペクトル
図8 フィッティング解析で得られた各サンプルの屈折率スペクトル
可視領域で透明な誘電体膜の場合,膜厚が数十ナノメーターより厚ければ,分光エリプソメーターほど高価な装置を使わなくても,干渉分光法で膜厚,光学定数の測定を行うことができます.


