HOME > 膜厚測定システム > 膜厚測定アプリケーション > 光学薄膜の膜厚測定と光学定数決定
光学薄膜の膜厚測定と光学定数決定
分光エリプソメーターの特長は,精密な膜厚測定,光学定数(屈折率: n ,消衰係数: k )スペクトル測定が行えることです. ここでは,酸化ハフニウム(hafnium oxide, HfO2)を例に,薄膜の膜厚測定,光学定数測定について解説します [1],[2].
[1] 田所利康:「第2章 光学特性の測定原理と測定法 2.5 分光エリプソメトリー(1)」,成形加工,28, 2 (2016) pp62-67.
[2] 田所利康:「第2章 光学特性の測定原理と測定法 2.6 分光エリプソメトリー(2)」, 成形加工,28, 3 (2016) pp102-106.
酸化ハフニウム膜の膜厚,光学定数測定
酸化ハフニウム(hafnium oxide, HfO2)は,無色の無機化合物で,紫外領域から赤外領域まで光を良く透過することから,光学コーティングの高屈折率材料として利用されます. 酸化チタン(TiO2),五酸化タンタル(Ta2O5)などの光学コーティング用高屈折率材料に比べると,バンドギャップが広く,紫外領域における透過特性が優れているという特長があります. また,HfO2およびその複合物は,高い誘電率を持つことから,二酸化ケイ素(SiO2)に代わるゲート絶縁膜用高誘電率(high-k)材料として注目されています.
図1に酸化ハフニウム膜サンプルの層構造と測定配置を示します. フィッティング解析の結果,若干の表面ラフネスを仮定した方がよい収束が得られたため,表面ラフネス層を入れてモデル化しています.
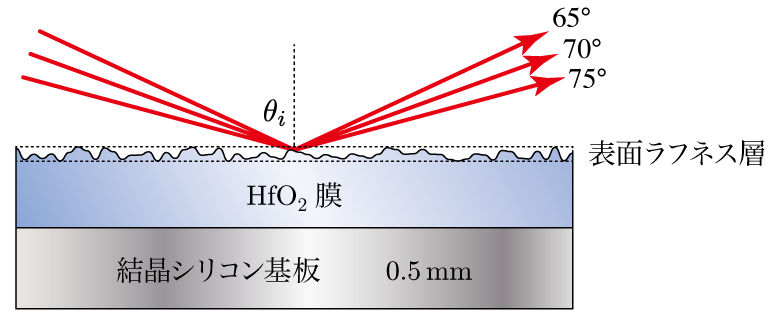 図1 酸化ハフニウム膜サンプルの層構造と測定配置
図1 酸化ハフニウム膜サンプルの層構造と測定配置
測定サンプル(ご提供:株式会社オプトクエスト)は,単結晶シリコン基板(厚さ:0.5 mm)上にイオンビームアシスト法(IAD: ion-beam assisted deposition)で成膜したHfO2膜です. 測定には回転補償子型分光エリプソメーター(J. A. Woollam社製 M-2000DI)を用い,波長範囲:190 nm 〜 1700 nmで測定しました. 本測定では,基板単結晶シリコンの主入射角(〜75.3°)付近を中心に,3入射角(65°,70°,75°)測定を行うことで精度の向上を図っています.
図2にΨ-Δの測定スペクトルとフィッティング解析結果を示します.
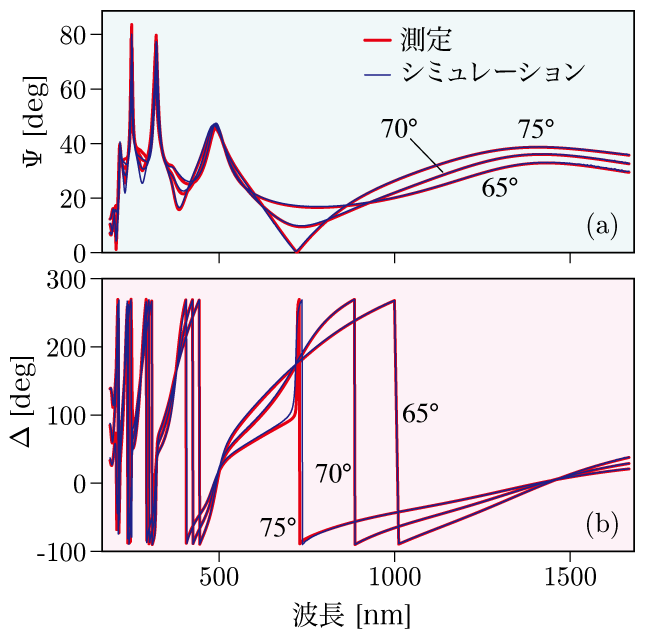 図2 (a) Ψスペクトル, (b) Δスペクトルと
図2 (a) Ψスペクトル, (b) Δスペクトルと各スペクトルに対するフィッティング解析結果
解析光学モデルは,表面ラフネス層(Bruggemanモデル [3]),HfO2層(Tauc-Lorentzモデル [4])の2層膜としました(図1).
表面ラフネス層の誘電関数は,有効媒質近似(EMA: effective medium approximation)を用いて求めました.
EMAでは,母体材料(真空)中に,球形の膜材料(HfO2)パーティクルが,ある体積分率で分散した層を仮定して,層の有効誘電関数を計算します.
Bruggemanモデルは最もポピュラーなEMAモデルです.
また,Tauc-Lorentzモデルは,アモルファス特有のバンドギャップ(Taucギャップ)にLorentzモデルを掛け合わせることで,ε2の非対称なピーク形状を再現するモデルです.
図2 (a), (b)の収束結果から,表面ラフネス層:3.89 nm,HfO2層:199.96 nmの膜厚値が得られました.
図3に解析で得られたHfO2膜の光学定数スペクトルを示します.
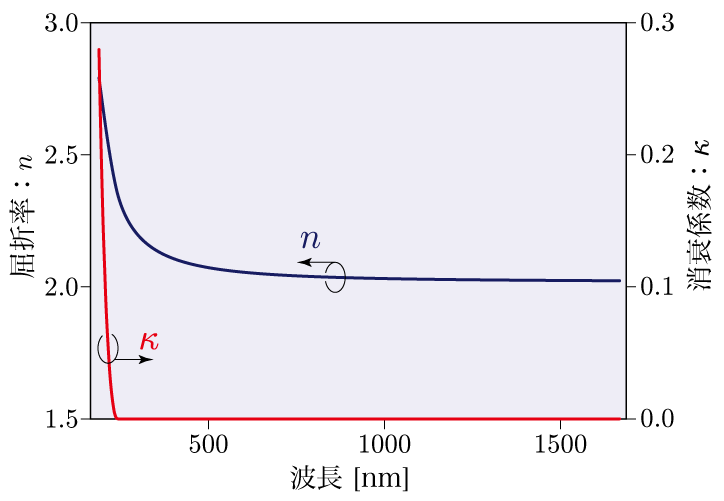 図3 HfO2膜の光学定数スペクトル
図3 HfO2膜の光学定数スペクトル
[3] D.A.G. Bruggeman: "Berechnung verschiedener physikalischer Konstanten von heterogenen Substanzen", Ann. Phys. (Leipzig), 24 (1835) pp.636-679.
[4] G.E. Jellison, Jr.:"Spectroscopic ellipsometry data analysis: measured versus calculated quantities", Thin Solid Films, 313-314 (1998) pp.33-39.


