HOME > 膜厚測定システム > 膜厚測定アプリケーション > 赤外領域における屈折率,消衰係数測定 1
赤外領域における屈折率,消衰係数測定 1
分光エリプソメーターは,精密な膜厚測定ができるだけではなく,精度の高い光学定数(屈折率: n ,消衰係数: k )の測定が可能です.赤外域多入射角分光エリプソメーター IRVASE Mark II(J. A. Woollam社)を使えば,近赤外から遠赤外領域にわたる広い波長領域1.7 〜 30µmで光学定数(屈折率: n ,消衰係数: k )を測定することができます.さらに,紫外可視近赤外の分光エリプソメトリーデータ(Ψ,Δ)と繋げて総合的に解析すれば,紫外から遠赤外領域をカバーする非常に広い波長領域の光学定数スペクトルを得ることができます.
[1] 田所利康:「広帯域化を遂げる分光エリプソメトリー」,光学,51, 10 (2022) 455.
Ta2O5膜の紫外〜遠赤外領域における光学定数スペクトル測定
五酸化タンタル(Ta2O5)は,SiO2,TiO2と並び誘電体多層膜に多用される光学膜材料です. ここでは,BK7基板上のTa2O5膜を例に,IRVASE Mark IIを用いて測定した近赤外〜遠赤外領域:1.7 〜 30µmのΨ,Δスペクトルに,回転補償子型分光エリプソメーター(J. A. Woollam社製 M-2000DI)を用いて測定したΨ,Δスペクトル(波長範囲: 193 nm 〜 1690 nm)を加えて,総合的に解析して求めた紫外〜遠赤外領域:0.193 〜 30µmにおけるTa2O5の光学定数スペクトルを示します.
測定サンプルは,ガラス基板(BK7,1 mm厚)上にイオンビームアシスト法(IAD: ion-beam assisted deposition)で成膜された設計膜厚:790 nmのTa2O5膜です.
測定には,赤外域多入射角分光エリプソメーターIRVASE Mark II(J. A. Woollam社)を用い,波長範囲:1.7 〜 30µm,入射角は50°,60°の2入射角で測定しました.
回転補償子型分光エリプソメーターM-2000DI(J. A. Woollam社)の測定で得られた波長範囲: 193 nm 〜 1690 nmのΨ,Δスペクトルを加えて,紫外から遠赤外領域にわたる波長領域0.193 〜 30µmで総合的に解析して光学定数スペクトルを求めました.解析の結果,表面ラフネス層:2.573 nm,Ta2O5膜の膜厚:779.956 nmが得られました.
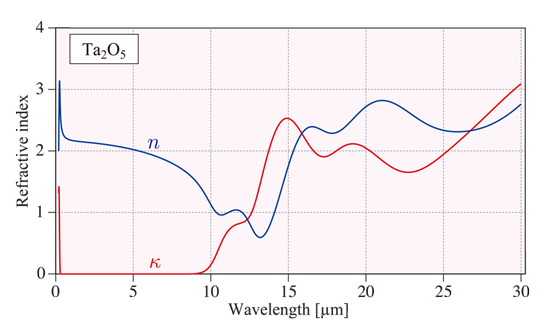 図1 Ta2O5の紫外から遠赤外領域における光学定数(波長リニア)
図1 Ta2O5の紫外から遠赤外領域における光学定数(波長リニア)
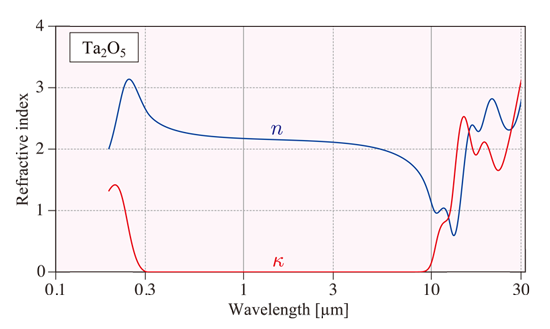 図2 Ta2O5の紫外から遠赤外領域における光学定数(波長対数)
図2 Ta2O5の紫外から遠赤外領域における光学定数(波長対数)
薄膜サンプルの光学定数などの光物性は,一般的に,成膜装置,成膜条件によって変化してしまいます.つまり,実サンプルの光学定数が文献値通りである保証はありません. 図3に,異なる成膜方式で成膜したTa2O5の紫外可視領域における屈折率スペクトルを示します.同じ材料を使った成膜でも成膜方式,装置,条件が違えば全く異なる光学定数を示すことが分かります.Jellisonの論文の時代(1992年)から成膜技術が格段に進歩していて,緻密で制御性の良い成膜が可能になりました.現在では,性能の良い成膜装置を使うことで高い屈折率を持つ安定した膜を付けることができるようになっています.
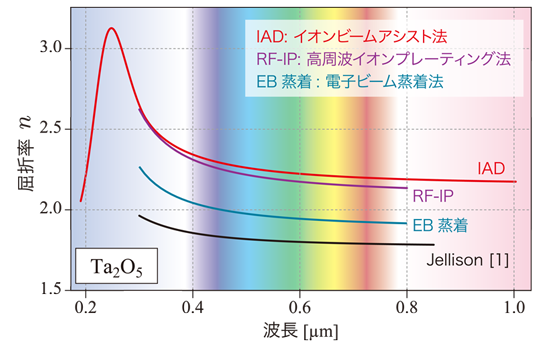 図3 膜の屈折率は成膜装置,成膜条件によって異なり文献値通りではない
図3 膜の屈折率は成膜装置,成膜条件によって異なり文献値通りではない
特に,赤外領域では充分な光学定数データがないなため,赤外領域における光学材料のアプリケーション開発では,正確な光学定数測定が必要になります.
[1] G. E. Jellison, Jr: "Optical functions of GaAs,GaP, Ge determined by two channel polarization ellipsometry", Opticals Materials, 1 (1992) pp.151-160.


