HOME > 徒然「光」基礎講座 > 膜厚測定・干渉分光法とは: 1. 薄膜計測について
膜厚測定・干渉分光法とは: 1. 薄膜計測について

1. 薄膜計測について
本講座では,膜厚測定,特に干渉分光法に付いて解説します. まずは,各種の膜厚測定法を概観しましょう.
1.1 実際の薄膜は理想的な状態とは限らない
一言で膜厚測定といっても,膜の材質,成膜方法,厚さ,成膜状態,測定目的など千差万別です. 実際の膜厚測定では,薄膜が絵に描いたような理想的な状態ばかりとは限りません.
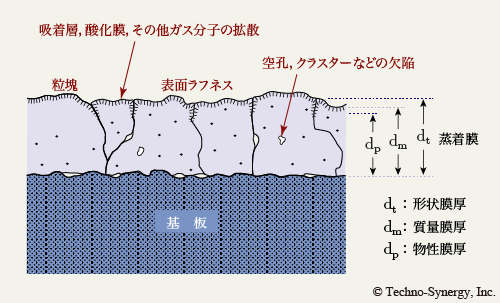
図1-1 に蒸着膜の仮想的な断面図を示します. 実際の薄膜測定の場面では,成膜法 / 成膜装置に起因する膜の不均質性など,解析を困難にする種々の問題に遭遇します. 例えば,膜表面を微視的に見ると,多かれ少なかれ表面ラフネスと呼ばれる凹凸構造があり,膜質や環境によっては水や不純物分子が吸着する場合もあります. また,膜内部では,粒塊,空孔やクラスターなどの欠陥,膜密度分布などが発生することも珍しくありません. これら膜質のアーティファクトは,薄膜作製時にできるだけ理想に近づける努力をするにしても,多かれ少なかれ存在して,測定誤差要因になります.
1.2 膜厚測定手法によって測る膜厚が異なる
膜厚測定において,これら膜質のアーティファクトがどのような形で測定誤差に影響するかは,膜厚測定手法によって異なります. 一般的な膜厚測定法は,形状膜厚測定法,質量膜厚測定法,物性膜厚測定法の三つに分けることができます.
AFM(Atomic force microscopy:原子間力顕微鏡)や触針式膜厚計に代表される形状膜厚測定法では,膜表面と基板表面との段差を直接計測するため,直感的に理解しやすい膜厚測定手法です. 形状膜厚測定法では,膜の最表面と膜のない基板表面との距離を膜厚と定義します.
膜質量から膜厚を求める質量膜厚測定法では,成膜モニターとして利用される水晶振動子法がポピュラーです. 質量膜厚測定法では,空孔などの内部欠陥の分が計測質量の誤差になります.
物性膜厚測定では,膜の電気的物性を膜厚測定に利用した電気抵抗法や,光学物性から膜厚を求める干渉分光法,エリプソメトリー,分光エリプソメトリーなどの手法があります. 物性膜厚測定法の中でも光学膜厚測定は,例えば,測定対象が光学素子であれば,膜厚と屈折率という光学素子に必須の量を換算ではなく測定で求めることができるという特長があります.

これらの膜厚測定法は,膜厚決定のメカニズムが異なるため,計測値が一致するとは限りません. むしろ,測定法ごとに「膜厚」の定義が異なっていると理解すべきでしょう. 例えば,図1-1 のような膜において形状膜厚測定を行った場合,膜密度などの膜質に影響されないため,他測定法と比べて厚めの膜厚定義となります.
膜の光学特性を議論する場合,膜厚および光学定数の二者を矛盾無く決定でき,膜の光学物性を反映した値が得られる光学的な物性膜厚測定法が,最も目的に合った測定法であることは明らかです.





